行業(yè)動(dòng)態(tài) 當(dāng)前位置:主頁(yè) > 關(guān)于丹普 > 動(dòng)態(tài)資訊 > 行業(yè)動(dòng)態(tài) >
磁控濺射法制備PVD薄膜晶格結(jié)構(gòu)分析
發(fā)布時(shí)間:2018-08-09
物理氣相沉積(PVD)技術(shù)制造火工品器件是一項(xiàng)新發(fā)展的技術(shù)。磁控濺射制備金屬薄膜是PVD的重要方法。在濺射鍍膜中,金屬靶材受到高能粒子轟擊作用,靶材表面的原子與高能粒子進(jìn)行能量交換,從靶材表面逸出,在磁場(chǎng)和重力作用下沉積到基底表面,經(jīng)薄膜生長(zhǎng)過程形成薄膜。由于PVD薄膜的形成過程是金屬原子重新組合排列的過程,因此,PVD薄膜的原子排列(即晶格結(jié)構(gòu))受到濺射條件的影響,有異于原金屬靶材的原子排列。PvD薄膜的這種晶格重新排列對(duì)薄膜的電阻率等物理性能有較大影響。為此對(duì)磁控濺射法制備的PVD薄膜晶格結(jié)構(gòu)與金屬靶材晶格結(jié)構(gòu)進(jìn)行了對(duì)比。分析研究了品格結(jié)構(gòu)發(fā)生變化對(duì)電性能變化的影響,以及消除此種影響應(yīng)采取的必要措施。
1、PVD薄膜制備及結(jié)構(gòu)分析
1.1 薄膜制備工藝及原理
濺射機(jī)理是動(dòng)能從碰撞粒子傳遞給晶體點(diǎn)陣粒子的過程。在最簡(jiǎn)單的情況下,動(dòng)能是從入射粒子傳遞給發(fā)射粒子,因而把入射離子與固體表面原子之間的濺射現(xiàn)象看作是純力學(xué)的彈性碰撞問題。粒子轟擊陰極,釋放出次級(jí)電子,后者與中性氣體原子碰撞,形成更多粒子。這些粒子再回到陰極,產(chǎn)生出更多的電子,并進(jìn)一步形成更多的粒子。當(dāng)產(chǎn)生的電子數(shù)正好形成足夠量的離子,這些離子能再生出同樣數(shù)量的電子時(shí),放電即達(dá)到自持。被濺射下來(lái)的靶材粒子在電場(chǎng)作用下沉積到基體表面,首先成核,在核的附近凝聚成島,最后連成片形成連續(xù)PVD薄膜。
試驗(yàn)中采用磁控濺射直流靶作為濺射源,靶材大小為Φ60cmX5cm,在靶材正下方6cm處放置基底材料,外加400V、0.3A電源,濺射0.5h,制得PVD薄膜材料。
1.2 濺射膜結(jié)構(gòu)測(cè)試
通常認(rèn)為PVD薄膜中微晶的晶體結(jié)構(gòu)與塊狀的晶體結(jié)構(gòu)相同,只是晶粒取向與晶粒尺寸不同。
試驗(yàn)中利用X衍射法對(duì)PVD薄膜晶體結(jié)構(gòu)與體材料晶體結(jié)構(gòu)進(jìn)行了對(duì)比分析。衍射圖如圖1和圖2所示。
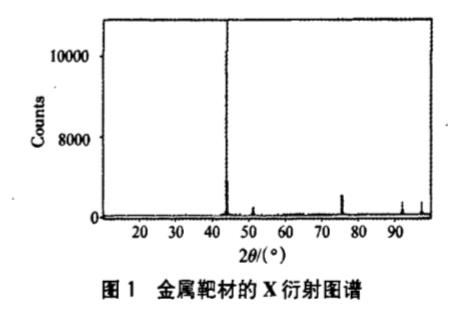

圖3中PVD薄膜與金屬靶材的X衍射圖譜特征峰2θ位置完全重合,其d值與靶材的衍射譜對(duì)應(yīng),為同一面心立方相,分別出現(xiàn)了(111)、(200)、(220)、(311)、(222)晶面。但從圖中可以看到,靶材衍射峰強(qiáng)明顯高于PVD薄膜衍射峰強(qiáng),且PVD薄膜衍射峰呈現(xiàn)寬化。

1.3 PVD薄膜衍射峰寬化分析
衍射峰寬化可以作為判斷一種物質(zhì)晶粒電性能發(fā)生變化的判據(jù)。通常,衍射峰窄而高,晶格缺陷少,晶粒電性能穩(wěn)定性好。而衍射峰寬,則存在較多晶格缺陷,電性能相對(duì)穩(wěn)定。
薄膜晶粒的大小是影響薄膜衍射峰寬的因素之一。晶粒細(xì)小的薄膜的XRD譜線呈寬化。當(dāng)晶粒小于10-5cm時(shí),由于晶體結(jié)構(gòu)完整性的下降和無(wú)序度的增加,衍射峰變寬,衍射角也發(fā)生2θ~θ的轉(zhuǎn)變。而且晶粒越小,寬化越明顯,直至轉(zhuǎn)變?yōu)槁⒎濉T囼?yàn)薄膜晶粒尺寸由Scherrer公式計(jì)算:

可求得晶粒在垂直(hkl)面方向的尺度D。K與晶粒形狀、分布等有關(guān),但通常取值為1(或0.9),λ為X射線波長(zhǎng),θ為Bragg角,B為衍射峰的半高寬,以弧度為單位。B的測(cè)算方法常用方法如下,見圖4。


式中:Bo、Bi分別為薄膜和標(biāo)準(zhǔn)粉末的半高寬。利用積分寬度將峰面積除以峰高可求得Bo、Bi。采用以上方法計(jì)算晶粒尺寸,由式(1)得:

本次衍射試驗(yàn)中,X射線波長(zhǎng)λ為1.5406A,K取1。由圖2可知衍射峰半高寬為0.017453,帶入式(4)得薄膜晶粒尺寸D1為9.526nm。
由圖1靶材衍射峰半高寬計(jì)算可得靶材晶粒尺寸D2為47.6nm。由此可以得出結(jié)論,薄膜晶面衍射峰寬化是PVD薄膜晶粒細(xì)小的原因之一。而用磁控濺射法制備出的薄膜晶粒尺寸小于金屬靶材晶粒尺寸,這是因?yàn)榇趴貫R射法制備薄膜時(shí),真空室中溫度較低,基片未經(jīng)過加熱處理,使達(dá)到基底表面的金屬粒子動(dòng)能減小,在基底表面上凝結(jié),只能得到很小的晶粒甚至得到無(wú)定形薄膜。
薄膜中存在晶格缺陷是衍射峰寬化的另一主要原因。薄膜中的晶格缺陷直接影響薄膜的各種電性能。這些缺陷主要包括點(diǎn)缺陷、線位錯(cuò)和堆積層錯(cuò)等。
在薄膜形成過程中所發(fā)生的蒸發(fā)、凝結(jié)等變化過程必然會(huì)產(chǎn)生很多缺陷。由于金屬薄膜的迅速凝結(jié),沉積的原子層還未來(lái)得及與基片達(dá)到熱平衡就被新層所覆蓋,這樣就會(huì)導(dǎo)致薄膜中有許多原子空位。
薄膜中因晶格畸變而出現(xiàn)位錯(cuò),分析其成因主要如下:
(1)由于薄膜在形成初期出現(xiàn)小島合并長(zhǎng)大的過程中島邊界晶格交接處發(fā)生了小角度扭曲。
(2)基片與薄膜間的晶格常數(shù)不同,不僅引起界面處品格畸變,還會(huì)導(dǎo)致小島間的畸變,當(dāng)這樣兩個(gè)小島合并時(shí),也會(huì)產(chǎn)生位錯(cuò)。同時(shí),在位錯(cuò)附近存在應(yīng)力集中,形成應(yīng)力場(chǎng),影響PVD性能變化。
通常,PVD薄膜的晶界比面積遠(yuǎn)大于塊狀材料,堆積層錯(cuò)的增多是薄膜材料電阻率比塊狀材料電阻率大的原因之一。
2、結(jié)論
通過分析表明,采用真空沉積磁控濺射技術(shù)制備PVD薄膜,所得XRD譜線呈現(xiàn)寬化,這是受PVD薄膜制備條件所限而較難避免出現(xiàn)的現(xiàn)象。磁控濺射法制備的PVD薄膜存在晶格缺陷,它直接影響PVD薄膜材料的性能,使其在使用過程中會(huì)出現(xiàn)性能不穩(wěn)定的情況。因此,要想獲得高質(zhì)量的PVD薄膜,在薄膜制備完成之后,還需對(duì)其進(jìn)行消除缺陷的處理,如退火處理、熱穩(wěn)定性處理等,以獲得性能穩(wěn)定的PVD薄膜材料。
聲明:本站部分圖片、文章來(lái)源于網(wǎng)絡(luò),版權(quán)歸原作者所有,如有侵權(quán),請(qǐng)點(diǎn)擊這里聯(lián)系本站刪除。
| 返回列表 | 分享給朋友: |








 京公網(wǎng)安備 11010502053715號(hào)
京公網(wǎng)安備 11010502053715號(hào)