EB-PVD制備硅基SiC薄膜及其性能研究
發布時間:2023-02-10
SiC材料硬度高、熱膨脹系數小、具有優良的高溫熱穩定性和熱導性,能夠很好地抵御高能中子輻射和α粒子的轟擊,因此廣泛應用于超高溫陶瓷涂層、抗熱輻射涂層和聚變堆包層結構材料等領域。EB-PVD是以電子束為熱源的一種蒸發鍍膜方法,在真空環境下利用高能量密度的電子束轟擊蒸鍍材料(金屬、陶瓷等)使之熔化、氣化、蒸發,在基片上沉積形成薄膜。與傳統的薄膜制備技術相比,EB-PVD技術具有蒸發和沉積速率高,基片與薄膜之間有較強的結合力等諸多優點,因此被廣泛應用于安全和民用領域。
本文采用EB-PVD技術,通過改變鍍膜時間、退火溫度等工藝參數,在單晶Si(100)基片上制備了SiC薄膜,采用AFM、XRD、臺階儀和半導體特性測試儀對SiC薄膜進行表征,研究EB-PVD技術制備SiC薄膜的工藝參數與薄膜表面平均粗糙度、電導率、結晶質量等性能的關系。
1、SiC薄膜的制備與表征
1.1 SiC薄膜的制備
實驗采用中國科學院沈陽科學儀器公司研制的DZS-500電子束沉積系統。選擇單晶Si(100)作為基片,并將其切割成10mm×5mm的方片。對基片分別用丙酮、乙醇和去離子水超聲清洗15min。靶材采用純度為98%的SiC壓片。坩堝和基片之間的垂直距離為500mm。在EB-PVD蒸發沉積過程中,E型槍所產生的高能電子束流將SiC靶材熔化蒸發,使其沉積到基板的Si片上形成薄膜,如圖1所示。沉積過程中真空度為6.7×10-3Pa,設定沉積速率為0.6nm/s,薄膜沉積時間分別為40、60min。電子束流強度30~60mA。沉積結束后繼續保持高真空狀態,待自然冷卻后,打開真空室取出試樣。對制備態試樣在2.0×10-2Pa真空中進行退火處理,退火溫度分別為600、900℃,退火時間均為2h,SiC薄膜制備工藝參數見表1所列。
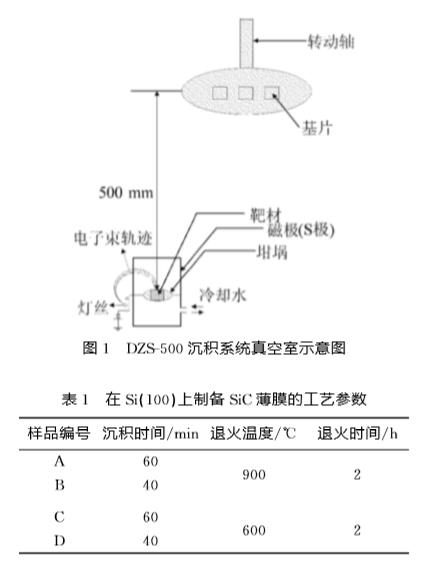
1.2 SiC薄膜結構分析
用X射線衍射儀(D/MAX2500V)、原子力顯微鏡(CSPM4000)、掃描電子顯微鏡(FEISirion200)、臺階儀(Xp-100)對SiC薄膜的結構、組織、形貌進行表征和分析,用半導體特性綜合測試儀(Keithley4200)測量薄膜的I-V曲線,進行電學性能評估。
(1)X射線衍射分析。圖2所示為沉積40min,厚度為1.5μm的SiC薄膜樣品B和D分別進行600、900℃真空退火后的XRD圖譜。由圖2可知,樣品經退火后,在34°均出現SiC(111)衍射峰。在900℃退火后,SiC(111)面的衍射峰強度顯著增加,同時在61°、65°出現了新的SiC(110)和(116)衍射峰。
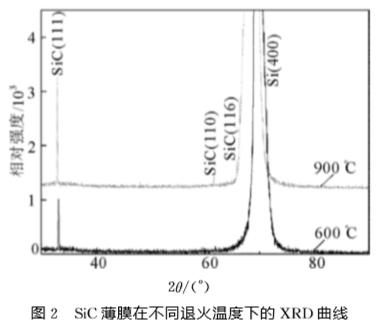
XRD結果表明隨著退火溫度的升高,SiC薄膜的結晶質量變好。
(2)SiC薄膜的AFM形貌分析。圖3所示的SiC薄膜的AFM掃描面積為25μm2,SiC薄膜表面形態光滑致密無空洞。SiC薄膜樣品A和C的平均粗糙度Sa分別為1.65、1.73nm,樣品B和D的Sa分別為5.39、7.90nm。這表明退火溫度越高,薄膜表面越平滑。因為隨著退火溫度提高,薄膜的結晶質量提高,結構致密。在相同退火條件下,沉積時間越長,薄膜厚度越厚,SiC粒徑大小趨于均勻化,使薄膜表面粗糙度降低。
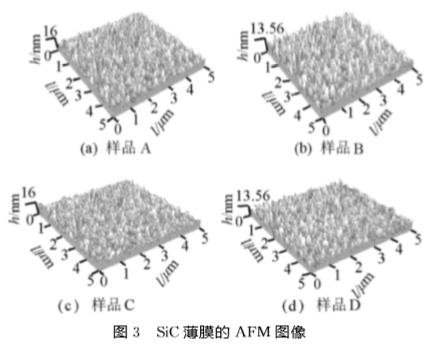
(3)SiC薄膜的SEM形貌分析。圖4所示為厚度為1.5μm的SiC薄膜樣品B經900℃退火2h后的SEM圖像。圖4表明,SiC薄膜晶粒的晶界清晰,結晶狀態良好,薄膜表面平整且致密。
(4)SiC薄膜的膜厚測量。使用臺階儀(Xp-100)測量SiC薄膜的厚度。圖5所示分別為樣品A、B的膜厚測試曲線,由圖5得到樣品A的膜厚約為2.0μm,樣品B的膜厚約為1.5μm。這表明鍍膜時間越長,沉積膜層越厚。
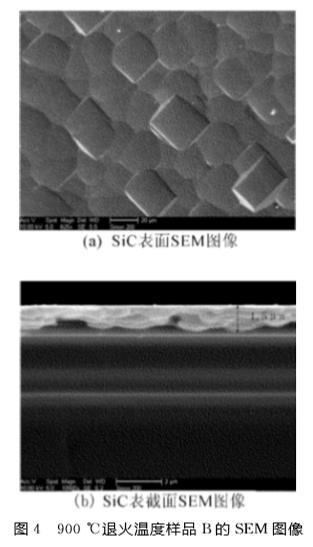
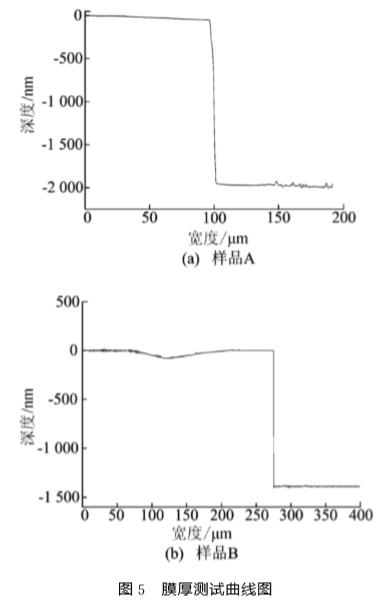
(5)I-V曲線測試。SiC薄膜的光電性質由I-V曲線表征。圖6a所示為膜厚1.5μm的樣品B在真空條件下900℃退火2h后,分別在紫外光、白光輻照和黑室條件下,在SiC薄膜上距離1mm2點所測的I-V曲線,圖6b所示為不同膜厚的樣品在真空條件下900℃退火2h后,白光輻照所測的I-V曲線。

圖6表明,經過900℃退火2h膜厚為1.5μm的SiC薄膜在3種不同輻照條件下,總體的趨勢相同,當施加相同電壓時,紫外光條件下所測的電流最大,白光次之,黑室電流最小;在相同的退火條件下,不同厚度的SiC薄膜,在白光照射下,施加相同電壓時,膜越厚,電流越大。這是因為當光照射半導體時,若光子的能量等于或大于半導體的禁帶寬度時,價帶中的電子吸收光子后進入導帶,產生電子-空穴對。這種類型的載流子亦稱光生載流子。光子的能量與頻率有關,當光照射到半導體時,就會產生光電效應。紫外光的頻率最大,產生的光電效應最大,而黑室下無入射光,產生的光電效應最小。SiC薄膜越厚,其含有的載流子數量越多,電流也就越大。
2、結論
采用EB-PVD法成功制備出SiC薄膜,通過實驗和分析得出以下結論:
①經過40min和60min的沉積時間,可在Si(100)基片上制備出厚度分別為1.5、2.0μm的SiC薄膜;
②在相同膜厚情況下,退火溫度越高,SiC薄膜結晶質量越好,薄膜表面平均粗糙度越低;在相同退火條件下,薄膜越厚,薄膜表面平均粗糙度越低;
③在SiC薄膜上施加相同的電壓時,紫外光照射下電流最大,白光次之,黑室電流最小,在相同輻照條件下,薄膜越厚,電流越大。
來源:合肥工業大學學報(自然科學版 )
①經過40min和60min的沉積時間,可在Si(100)基片上制備出厚度分別為1.5、2.0μm的SiC薄膜;
②在相同膜厚情況下,退火溫度越高,SiC薄膜結晶質量越好,薄膜表面平均粗糙度越低;在相同退火條件下,薄膜越厚,薄膜表面平均粗糙度越低;
③在SiC薄膜上施加相同的電壓時,紫外光照射下電流最大,白光次之,黑室電流最小,在相同輻照條件下,薄膜越厚,電流越大。
來源:合肥工業大學學報(自然科學版 )
聲明:本站部分圖片、文章來源于網絡,版權歸原作者所有,如有侵權,請點擊這里聯系本站刪除。
| 返回列表 | 分享給朋友: |








 京公網安備 11010502053715號
京公網安備 11010502053715號